现代磁控溅射的基础专利于1970年代初提交。 尽管溅射的基本原理早在很久以前就被发现,但商业上可行的、高速率磁控溅射工艺的开发归功于Telic公司的John Thornton和Alan Penfold等研究人员,以及Battelle Northwest实验室在1973-1974年左右所做的工作。
磁控溅射的发明与其说是一项单一的发现,不如说是一次关键的演变。通过在溅射靶材后面增加磁场,工程师们解决了阻碍溅射成为主导工业技术的速度和热量方面的根本限制。
前身:理解问题
在磁控溅射之前,主要的方法是二极溅射。这种早期技术在研究中很有用,但对于许多大规模生产应用来说效率太低。
溅射的发现
这种潜在的物理现象最早由William Grove于1852年观察到。他注意到放电管中的阴极逐渐被侵蚀,被侵蚀的材料沉积在附近的表面上。这个过程,即离子轰击靶材并喷射出原子,是所有溅射的基础。
二极溅射的局限性
一个多世纪以来,二极溅射一直是一种缓慢、低效率的工艺。它的主要缺点是低沉积速率和显著的衬底加热。
效率低下源于电子的行为方式。在二极系统中,电子逸出等离子体并轰击衬底,以热量的形式传递大量能量。这限制了可以涂覆的材料类型,并使该过程对于工业用途来说太慢。
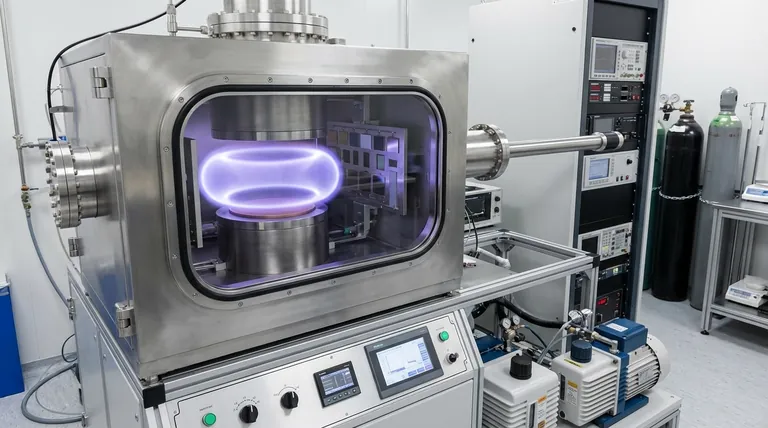
突破:限制电子
磁控溅射的精妙之处在于在靶材后面引入了永磁体阵列。这种看似简单的添加彻底改变了等离子体的动力学。
核心创新:磁阱
磁场在靶材表面正前方为电子创建了一个“隧道”或陷阱。电子不再逸出并撞击衬底,而是被迫进入螺旋路径,大大增加了它们在等离子体内的行程距离。
这立即产生了两个变革性的影响。首先,它极大地增加了电子撞击并电离气体原子(通常是氩气)的概率。其次,它将高能电子限制在远离衬底的地方。
结果:稳定、高密度的等离子体
随着产生更多离子,对靶材的轰击变得效率更高。这在需要的地方——靶材表面——精确地创建了致密、稳定的等离子体。
这项创新直接解决了二极溅射的核心问题,将实验室的好奇心变成了工业强国。
磁控溅射解决的问题
这项发明不仅仅是渐进式的改进;它是一次根本性的转变,为薄膜制造开辟了新的可能性。
沉积速率大幅提高
通过创建更强烈、更有效的离子轰击,磁控溅射将沉积速率提高了一到两个数量级。过去需要数小时才能完成的工艺现在可以在几分钟内完成,使其适用于从微芯片到建筑玻璃等各种产品的大批量制造。
衬底加热减少
由于磁场将电子限制在靶材附近,衬底免受强烈的电子轰击。这显著降低了热负荷,从而可以在不造成损坏的情况下,将高质量薄膜沉积到塑料和聚合物等热敏材料上。
更低的操作压力
改进的电离效率意味着可以在更低的气压下维持稳定的等离子体。在更低压力下溅射导致喷射出的靶原子发生的气相碰撞更少,从而产生更高纯度、更致密的薄膜,并具有更好的附着力。
理解这项发明的遗产
磁控溅射的发展是材料科学和制造领域的一个关键时刻。它的优势直接解决了大多数现代薄膜应用的目标。
- 如果您的主要关注点是高通量制造: 沉积速率的显著提高是这项发明的关键遗产,它使得大面积和复杂部件的经济高效涂覆成为可能。
- 如果您的主要关注点是涂覆精密材料: 电子限制带来的衬底加热减少是关键特性,它允许涂覆聚合物、塑料和其他敏感衬底。
- 如果您的主要关注点是高质量光学或电子薄膜: 在更低压力下操作的能力产生更纯净、更致密的薄膜,具有卓越的性能,这是磁控管高效等离子体限制的直接结果。
最终,磁控溅射的发明将薄膜沉积从一种专业的科学工艺转变为一种基础的工业制造技术。
总结表:
| 关键里程碑 | 年份/时期 | 主要创新者/贡献者 |
|---|---|---|
| 溅射现象的发现 | 1852 | William Grove |
| 二极溅射的发展 | 20世纪初 | 多位研究人员 |
| 磁控溅射的发明 | 1973-1974 | John Thornton, Alan Penfold (Telic Corp), Battelle Northwest Labs |
| 核心创新 | 1970年代初 | 利用磁场限制电子 |
准备好在您的实验室中利用现代磁控溅射的力量了吗? KINTEK专注于高性能实验室设备和耗材,提供能够实现当今研究和制造所需的高沉积速率、低衬底加热和卓越薄膜质量的解决方案。我们的专业知识帮助实验室实现精确、高效的薄膜沉积。立即联系我们,讨论我们的溅射系统如何提升您的工作!
图解指南

相关产品
- 微波等离子体化学气相沉积MPCVD设备系统反应器,用于实验室和金刚石生长
- 化学气相沉积 CVD 设备系统 腔体滑动式 PECVD 管式炉 带液体汽化器 PECVD 机
- 钼钨钽特形蒸发舟
- 倾斜旋转等离子体增强化学气相沉积 PECVD 设备管式炉
- 倾斜旋转等离子体增强化学气相沉积 PECVD 设备管式炉



















